info@universallab.org
WhatsApp: +41762172997


Price may vary based on selected options
Delivery time: 1 ~ 2 weeks

Secondary Ion Mass Spectrometry (SIMS) is a highly sensitive technique used to analyze the composition of solid surfaces and thin films. It works by bombarding the sample with a focused ion beam, which sputters atoms and molecules from the surface. Some of these become ionized (secondary ions) and are analyzed by a mass spectrometer to determine their mass-to-charge ratio.
SIMS is especially useful for depth profiling and trace element detection, with applications in semiconductors, materials science, geology, and more. It can detect almost all elements, including light ones like hydrogen, down to very low concentrations (ppb level).

Static Secondary Ion Mass Spectrometry (Static SIMS) focuses on analyzing the very top surface layer of a sample—typically the outermost 1 to 3 atomic layers. In this mode, the primary ion beam has a low energy, usually around 100 eV, and only a very small number of atoms are sputtered from the surface during analysis. This ensures that the surface remains largely intact, making Static SIMS a non-destructive technique ideal for surface chemistry and molecular studies. The extremely low sputter rate allows detailed characterization of surface composition without altering the original structure.
Dynamic Secondary Ion Mass Spectrometry (Dynamic SIMS) is designed for depth profiling, revealing how elemental composition varies below the surface. In this mode, the primary ion beam has a higher energy, typically between 1–10 keV, and it sputters a significant amount of material from the surface with each pass. This leads to gradual erosion of the sample surface, allowing deeper layers to be exposed and analyzed. The higher sputter rate enables rapid acquisition of depth information, making Dynamic SIMS well-suited for quantitative analysis of layered structures, dopants, and trace elements in materials.


1. Caption: D-SIMS Doping depth analysis.
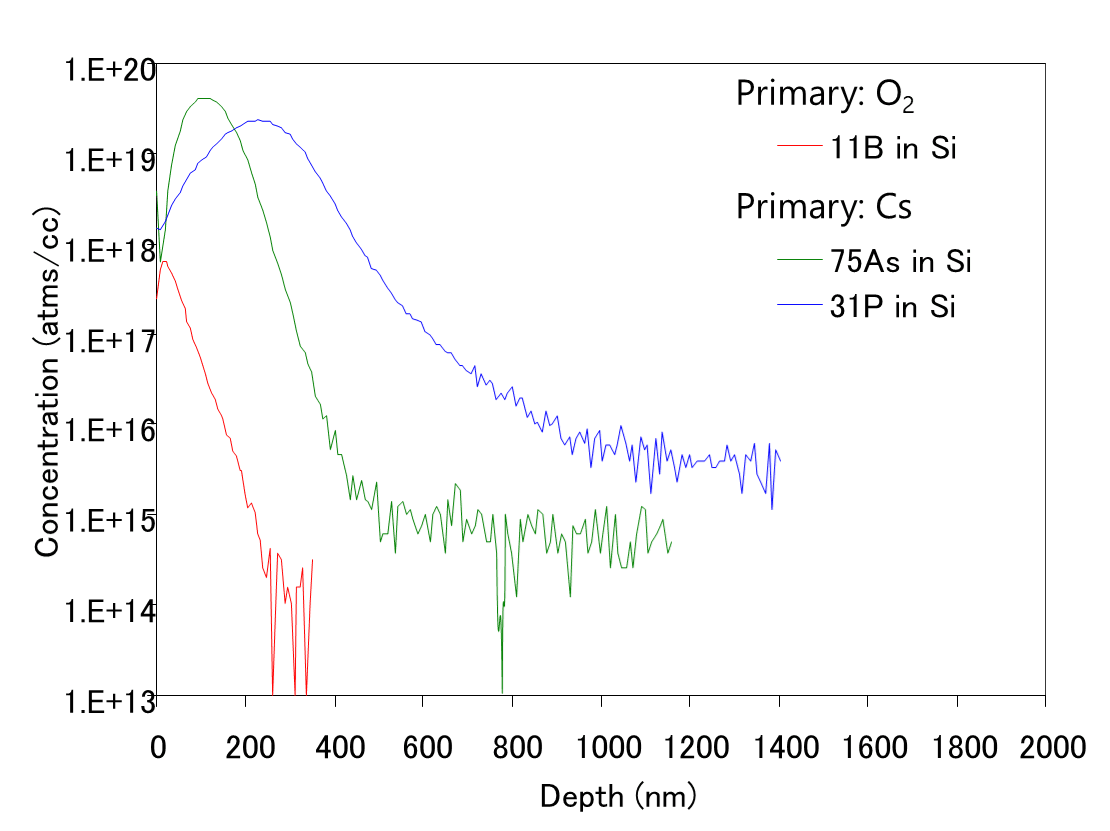
2. Caption: TOF-SIMS Depth Profiling & Data Analysis.
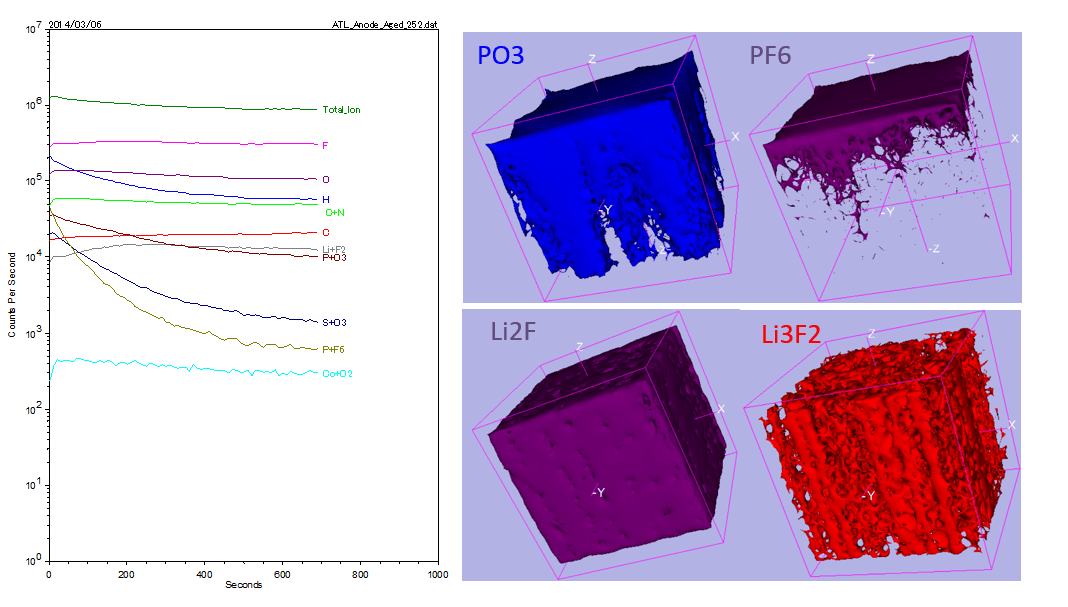
| Category | TOF-SIMS Sample Requirements | D-SIMS Sample Requirements |
|---|---|---|
| Applicable Sample Types | Powder, bulk solids, and flat-surfaced materials. Suitable for surface chemical analysis and mapping. | Solid thin films or flat, smooth surfaces such as substrates or deposited layers. Used for depth profiling and quantitative analysis. |
| Sample Size | - Bulk: ≤ 1.1 cm (L/W), thickness ≤ 5 mm- Powder: ≥ 50 mg | - Size: 5–10 mm- Thickness: ≤ 1 mm- Clearly mark the test surface |
| Sample Preparation | - Powders must be dry, dehydrated, and vacuum sealed- Moisture-sensitive or oxidizing samples require pre-arranged testing and vacuum sealing- Avoid sticky plastic bags, tapes, or adhesive films | - Store samples in vacuum- Powders, packaged, or structured samples require additional sample preparation |
| Vacuum Stability | Must be stable under ultra-high vacuum (UHV) and free from corrosive/volatile emissions | Same as TOF-SIMS: must be UHV-compatible and chemically stable |
| Analysis Mode | - Mainly used for surface mass spectrometry and 2D mapping- Not used for depth profiling | - Used for depth profiling and trace analysis- Quantification possible with suitable standards (e.g., B, P, As in silicon) |
| Analysis Depth | Top 1–2 nm of the surface; extremely surface-sensitive | Typical analysis depth: <5 µm, max ≤10 µm |
| Analysis Area | Flexible; typically small areas (tens to hundreds of µm²) | Standard areas: 100 × 100 µm², 200 × 200 µm², 300 × 300 µm²Larger areas = slower sputtering |
Secondary Ion Mass Spectrometry (SIMS) is a surface analysis technique that uses a focused ion beam to ablate the sample layer by layer. As material is sputtered from the surface, secondary ions are emitted and analyzed by a mass spectrometer. This enables precise chemical characterization of the sample as a function of depth, making SIMS especially useful for generating depth profiles of elemental and isotopic composition.